PECVD工艺:半导体产业薄膜沉积环节的价值引擎
1、PECVD成膜原理介绍
传统CVD技术虽能实现高精度薄膜,但800℃以上的沉积温度却让热敏材料望而却步。如何在低温下实现高效、高质量的薄膜沉积?PECVD通过引入等离子体进行反应,将沉积温度降至100~400℃,同时通过活性粒子加速反应,使沉积速率提升10倍以上。
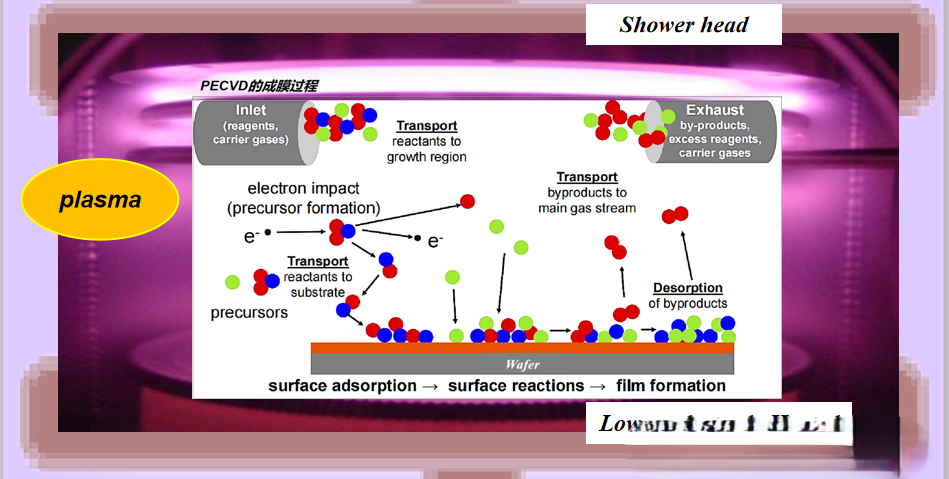
2、等离子体
在PECVD系统中,通过射频(RF)或微波电源在反应腔室内施加电场,使通入的气体(如SiH4、NH3等)电离形成等离子体。
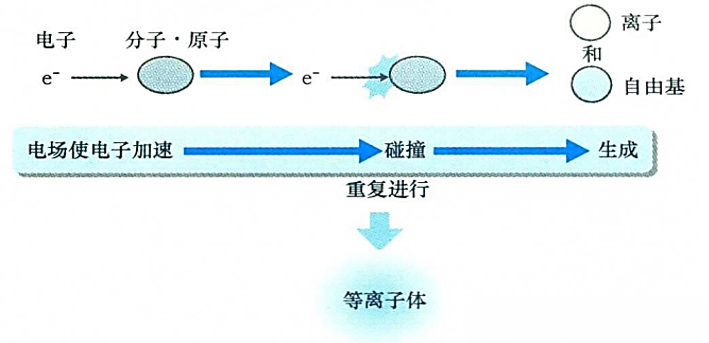
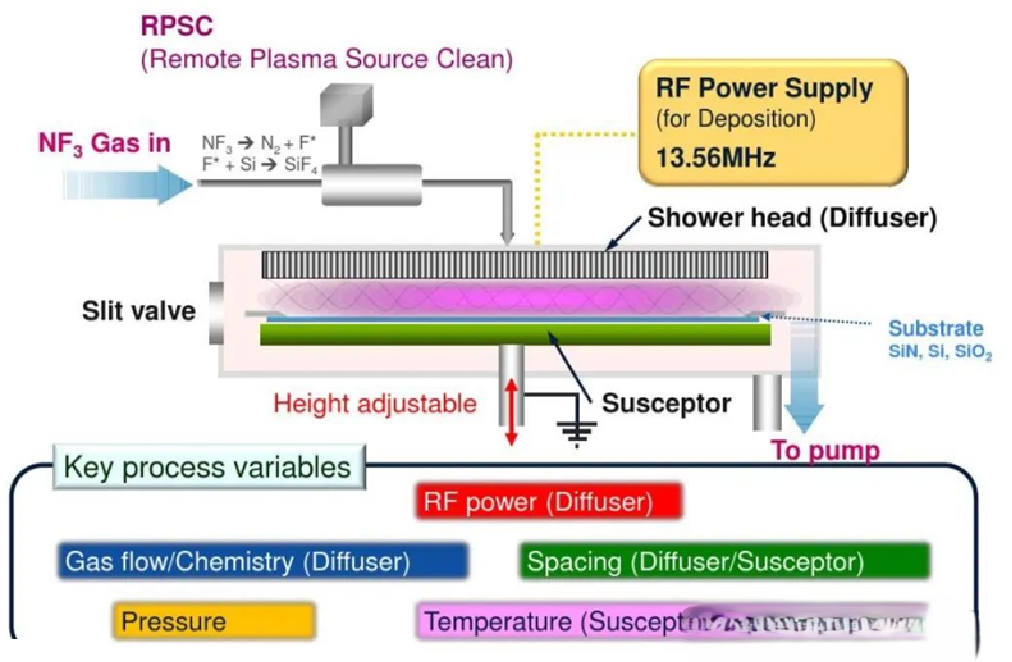
*成膜核心:
通过高能量(Plasma)将物质(源气)之间的化学键破坏,并重新组合(新物质,如SiNx、SiOx、SiONx等)。
*关键控制:气场、流场
(这里的气场指的是:Chamber内部的气体压力的控制,因为腔体内的压力是实时变化的,所以好的流量计、压力计、蝶阀、PID反馈调节就很重要,波动太大,会导致产品不稳定,反应阶段的生成与消耗要维持在动态平衡,这样才能保证每一个产品都是一致的;流场指的是:源气从进入Chamber后到流出Chamber的整个过程中,气流的动态过程,所以,这就是为什么我们一直关注腔体环境的原因。如果腔体内壁洁净度不足,会导致靠近内壁的流场中的反应源被过度消耗,沉积过程受到干扰,哪怕周围的Parts表面轻微划痕或磕碰都绝对会影响局部流场)
3、工艺指标:
① Dep temp——沉积温度
② Thickness——薄膜膜厚
③ Refractive Index(RI)——折射率
④ Stress——薄膜应力
⑤ Dep Rate——沉积速率
⑥ Uniformity (WIW)——薄膜片内均一性(值越小,均一性越好)
⑦ Uniformity (WTW)——薄膜片间均一性(值越小,均一性越好)
⑧ Particle spec——薄膜表面颗粒要求
⑨ BOE Etch Rate——薄膜刻蚀速率(表征薄膜致密性的参数)
4、参与反应的气体 (以SiNx为例):
SiHx 、NHx(通常为:SiH4 、NH3)
5、反应式:
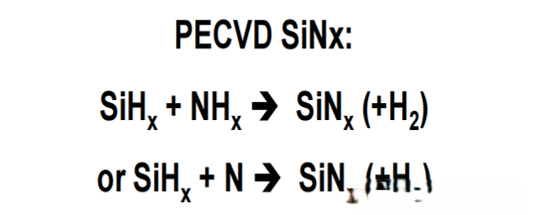
6、影响说明:
因为每一个项目的要求都是不同的,所以要根据自己的需求进行调试。
a. 调试的核心思想:
①先固定化合物的比例;
(主要影响:对RI有着绝对的影响,PECVD的调试比较难,因为影响因素比较多,我们在调整了它的比例和流量的同时,其实它的空间气体组氛也有变,一般情况下,当我们的Target很接近Spec的时候,N/Si比例是要保持不变的,然后可以根据你的测试数据来进行微调)
②工艺参数(Pressure、Temp、Gas flow、Gas Rate、Time、Power等)在一定范围内是线性的。

(举例说明:一定情况下,温度升高,气体活化能提高,反应加剧,会加速沉积速率;记住,我这里只说的是一定温度下,因为温度过高,气体活化能饱和,沉积速率将几乎不变,均一性还会急剧变差,折射率RI也可能变差。这就是PECVD工艺的难点,你在考虑或调平其中一个指标参数的时候,其他参数指标可能变化很大,这时候是需要综合去考虑的)
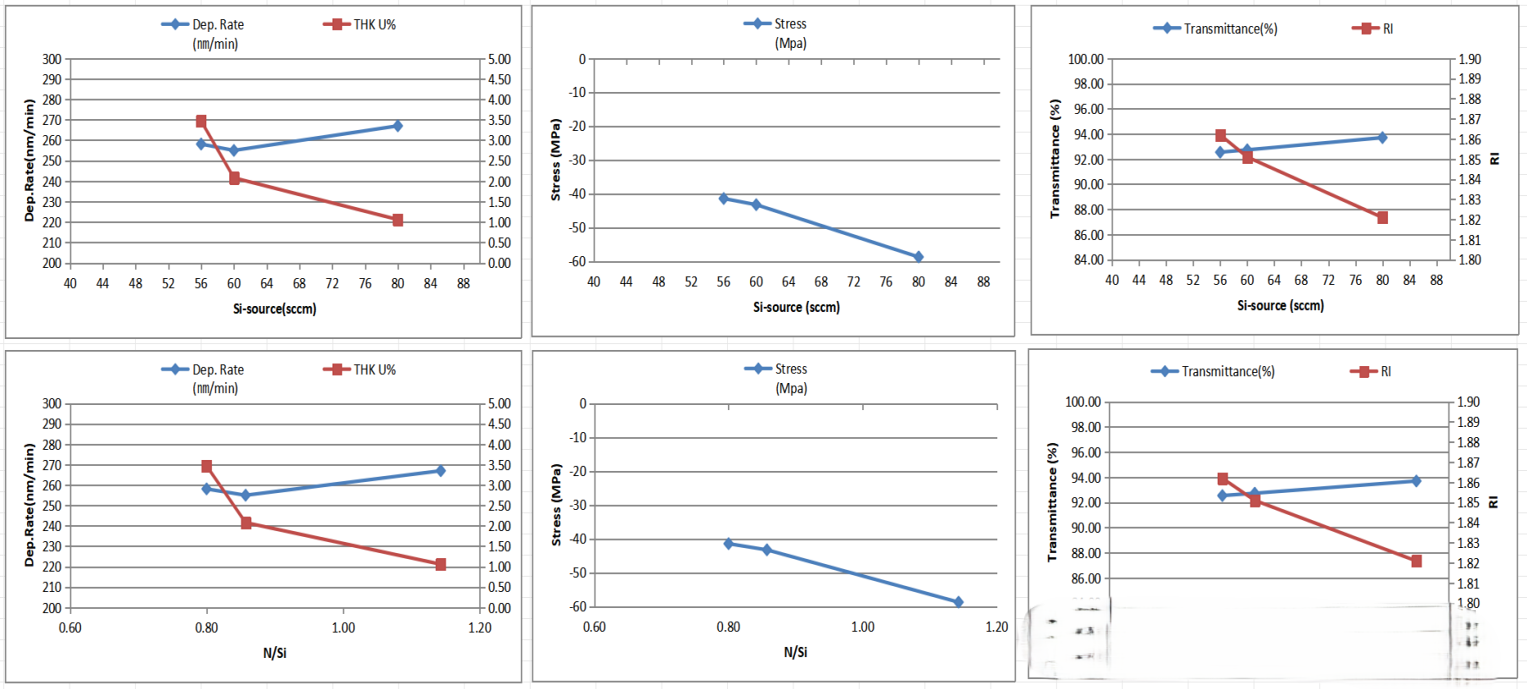
b、牢记硬背:
SiNx薄膜中:Si组氛越多,RI值越大,N组氛越多,RI值越小。
c、经验分享:
最好的Recipe一定是所有的Gas Flow全部处于MFC的量程中间值。
d、切勿操作:
PECVD的极板间隙过大,不容易起辉;过小,极板容易被击穿。
e、笔记分享:
极板式PECVD 原理思考,仅供参考:

不同的工艺对标要求不太一样,仅供参考:

不同的设备,配置不太一样,仅供参考:

安徽博芯微半导体科技有限公司,为核心组件提供高精度Showerhead服务,产品主要包括Shower head、Face plate、Blocker Plate、Top Plate、Shield、Liner、pumping ring、Edge Ring等半导体设备核心零部件,产品广泛应用于半导体、显示面板等领域,性能卓越,市场认可度高。
信息来源:半导体大军公众号